

目前的共聚焦顯微鏡都使用有著可移動機械裝置的鏡面掃描頭,
這會限制其使用壽命,并且在高倍率時降低像素抖動優化效果。
對于共焦掃描,neox使用基于微型顯示器的Sensofar專利技術。
該微型顯示器基于鐵電液晶硅(FLCoS),一種沒有運動部件的快速
切換裝置,使共焦圖像的掃描更快速、穩定并擁有無限的壽命。

■ 彩色CCD攝像頭
Neox使用一個高速高分辨率的黑白CCD攝像頭為系統計量探頭。
另一個彩色攝像頭可用于明場表面觀察。這樣使得它很容易找
出所分析樣品的特點。此外,地貌測量功能可得到全聚焦彩色
圖像。該系統在垂直掃描過程中記錄圖像合焦位置像素,并和
其Z軸位置匹配從而得到全聚焦彩色圖像,并以此來創建出色的三維模型。

■ 物鏡
Neox使用獨特的CFI60 Nikon物鏡,在各NA時都有最大的工作距離。
可選用的物鏡超過50種,每一款都可對應某種特別應用:可用于共聚焦
成像和建模的較高NA,倍率范圍2.5X至200X,超長工作距離,特長工作
距離及浸水物鏡;帶調焦環的物鏡可在最厚2mm范圍的透明介質對焦;
2.5X至100X帶參考鏡校正及頂端傾斜的物鏡。

■ 雙垂直掃描器
雙垂直掃描器包括一個電動平臺和壓電掃描器,以獲得最高的掃描范圍和
最高的測量精度及重復精度。高定位精度的線性平臺行程40mm,最小步進
可達10nm,用于共聚焦掃描非常理想。集成的壓電掃描器最高掃描范圍200μm,
壓電電阻傳感器高定位分辨率0.2nm,全行程精度1nm。現有的其它掃描平臺使
用光學編碼器,精度僅30nm且不確定,限制了系統的精確度和重復性。結合線
性平臺和壓電掃描器的獨特設計,使Neox在0.1納米至幾毫米測量范圍內擁有業
界最高的精度,線性和重復性。
■ 集成反射光譜儀
共聚焦及干擾法測量薄膜厚度的實際限制約為1μm單層膜。Neox集成了一個反射
光譜儀,通過光纖進行薄膜的測量,厚度范圍在10nm,最高可達10層膜。該光纖
通過顯微目鏡成像,因此,薄膜測量點尺寸最小可達5微米。測量使用集成的LED
光源,可提供樣品以及薄膜測量的實時明場影像。
■ 雙LED
照明光源內置了兩個高功率LED,其中白光LED用于彩色明場觀察,薄膜測量,VSI和ePSI。
另一個藍光LED用于高分辨率共聚焦影像和PSI。藍光LED較短的波長可有效提升水平分辨率
至0.15μm(L&S),并改善PSI噪聲為0.01nm垂直分辨率。
■ 高速度 (12.5 fps 共聚焦幀速率)
基于FLCoS微型顯示器的高速轉換速度和特有的快速共聚焦算法,本設備可達到12.5幀/秒的
共聚焦圖像幀率,垂直3D掃描達到8層/秒,這意味著3D共焦測量掃描速度范圍為0.5至350μm/s。
干涉掃描速度為50 fps,即垂直掃描速度高達800μm/s。一次典型的測量時長,其中包括掃描后
的運算,通常小于5秒。
主要功能
共聚焦
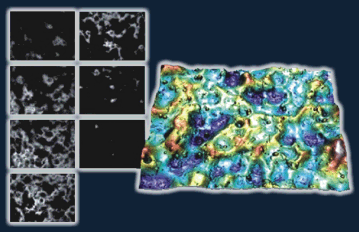
共聚焦輪廓儀可以測量較光滑或非常粗糙的表面高度。借助消除虛焦部分光線的共焦成像系統,
可提供高對比度的圖像。籍由表面的垂直掃描,物鏡的焦點掃過表面上的每一個點,以此找出
每個像素位置的對應高度(即共聚焦圖像)。
共聚焦輪廓儀可以由其光學組件實現超高的水平解析度,空間采樣可以減小到0.10μm,這是一
些重要尺寸測量的理想選擇。高數值孔徑NA(0.95)和放大倍率(150X和200X)的物鏡可測量斜率
超過70°的光滑表面。neox具有極高的光效,專有的共聚焦算法可提供納米級的垂直方向重復性。
超長工作距離(SLWD)可測量高寬比較大、形狀較陡的樣品。

● PSI 模式
相位差干涉儀 (Phase Shift Interferometers)可以亞納米級的分辨率測量非常光滑與和連續的表面高度。
必須準確對焦在樣品上,并進行多步垂直掃描,步長是波長的精確的分數。PSI算法借助適當的程序將
表面相位圖轉換為樣品高度分布圖。
PSI模式可在所有的數值孔徑(NA)下提供亞納米級的垂直分辨率。放大倍率較小時(2.5X)可以測量較大
視場范圍,并具有同樣的垂直分辨率。但是光波相干長度使其測量范圍限制在微米級。PSI算法使neox
得到納米尺度的形態特征,并以亞納米尺度對超平滑的表面紋理參數作出評估。
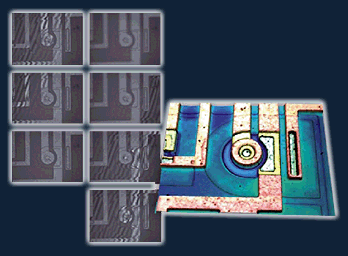
VSI 模式
白光干涉儀 (White-Light Vertical Scanning Interferometers)可用于測量光滑表面或適度粗糙表面的高度,
當樣品表面各個點處于最佳焦點位置時可得到最大干涉條紋對比度。多步垂直掃描樣品,表面上的每一個
點會通過對焦點,通過檢測干涉條紋峰值得到各像素位置的高度。
VSI模式可在所有的數值孔徑(NA)下提供納米級垂直分辨率。VSI算法使neox在各放大倍率下得到具有相同
垂直分辨率的形態特征。其測量范圍在理論上是無限的,盡管在實踐中其將受限于物鏡實際工作距離。掃描
速度和數據采集速率可以非常快,當然這會導致一定程度垂直分辨率損失。

薄膜測量
光譜反射法是薄膜測量的首選方法之一,因為它準確、無損、迅速且無需制備樣品。測量時,白光照射到樣品
表面,并將在膜層中的不同界面反射,并發生干涉和疊加效應。結果,反射光強度將顯示出波長變化,這種變
化取決于薄膜結構不同層面的厚度和折射率。軟件將測得的真實光譜同模擬光譜進行比較擬合,并不斷優化厚
度值,直到實現最佳匹配。
Neox也可用作高分辨率的薄膜測量系統,它適用于單層箔,膜或基板上的單層薄膜,而且還可以處理更復雜結
構(最高可至基板上10層薄膜)。可在一秒內測量從10nm到20μm的透明薄膜,厚度分辨率0.1 nm,橫向分辨率達5μm。
應用舉例
表面形貌觀測
太陽能硅片的表面,不論是多晶還是單晶,在微觀下表面的起伏都相當劇烈。傳統的分析設備,很難講形貌最正確地顯示和測量。PLu設備因為具有可以量測大斜率的優勢,所以可將表面呈現得相當完整。

白光干涉測量功能
白光干涉儀可進行光滑表面或粗糙表面的高度測量,尤其是垂直度較大的樣品(柵線),相對于共聚焦的分析模式速度快,精度高。對太陽能電池片的檢測,必須要有共聚焦模式和干涉模式才可以對樣品進行全面而準確的分析。